
半導体でのエッチングって何の目的でやってるの?
エッチングは半導体製造工程のリソグラフィプロセスで利用される微細加工技術の一つで、加工には物理的にやる方法もあれば、化学的にやる方法もあります。
- この記事を読むことで、半導体におけるエッチング処理が分かります
- エッチング処理の目的
- エッチングに必要なもの
半導体におけるエッチングの目的
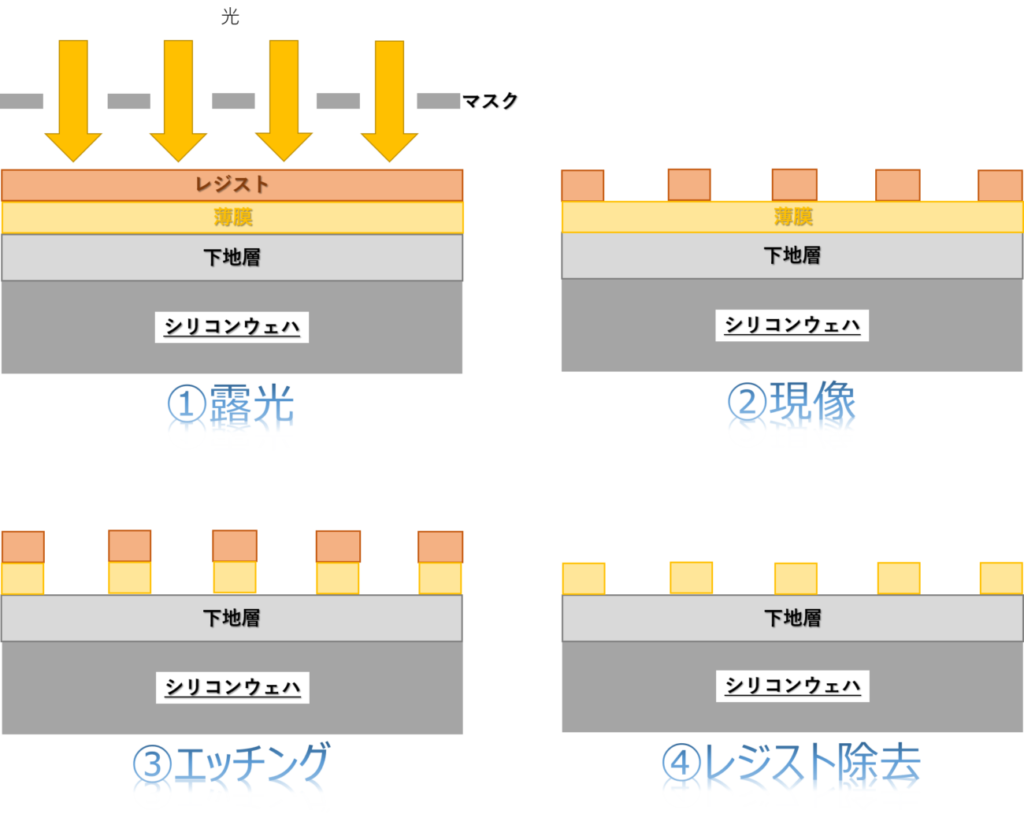
リソグラフィプロセス
エッチングを説明するにはリソグラフィプロセスの全体を知る必要がありますが、リソグラフィプロセスの順序は…
となっており、図で言う③がエッチングを絵にしたものになります。
エッチングの目的を言葉にすると、レジストで被服されていない部分の薄膜を選択的に除去する工程になります。
現在、半導体業界ではドライエッチングという方法で、エッチング処理をしています。
エッチング方法(ドライエッチングの工程)

エッチングで求められる性能
- 加工精度
- 選択性
エッチングでとにかく求められるのはレジストでパターン形成された絵の通りに微細加工できる事で、ドライエッチングでは物理的にエッチングできるイオンと、化学的にエッチングできるラジカルの両方を使って、エッチングしています。
イオンによるエッチング

ラジカルによるエッチング

異方性と等方性
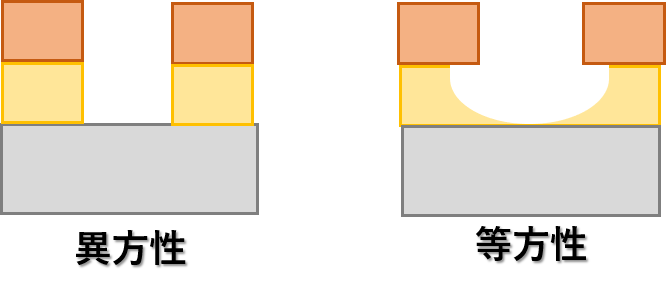
等方性の高いラジカルによるエッチングは、ラジカルが吸着したところからエッチングしていくので、直進性が無く放射状に広がってしまい、薄膜を下までエッチングする頃にはレジスト寸法よりも小さくエッチングしてしまう欠点があります。
選択比

異方性のあるイオンによるエッチングは選択比が低く、被覆しているレジストや下地をエッチングし過ぎてしまいます。
一方、ラジカルによるエッチングは薄膜のエッチング速度が速く、レジスト選択比や下地選択比が大きいくなります。
そのため、イオンとラジカル両方のメリットを利用することで、理想的なエッチングが実現しています。
エッチングに必要な物
これまでエッチングの目的を説明してきましたが、ここではエッチングをする際に必要なものを以下に記載します。
エッチングガス
ドライエッチングは物理的もしくは化学的によってエッチングしますが、化学的な反応を利用してエッチングする場合に一つ注意点があります。
それは、反応によって出てきた生成物の沸点が、エッチング時の温度よりも低い事。
つまり、反応生成物が蒸発して初めて化学的なエッチングができます。
ここで反応生成物が蒸発しないと表面に残ってしまい、エッチングが出来なくなってしまいます。
プラズマ

プラズマは固体、液体、気体に次ぐ第4の流体と呼ばれ、原子周囲の電子が電離している状態です。身近な例で言えば、太陽表面のコロナは非常に高温でプラズマ状態になっていると言われています。
太陽の表面でプラズマ状態になるくらいなので、物質がプラズマになるには大きいエネルギーが必要でした。
しかし、人類の進歩により低温でもプラズマができる環境を見つけ、半導体製造工程で活かされています。

この低温プラズマは手で触る事ができます。
平均自由工程

装置
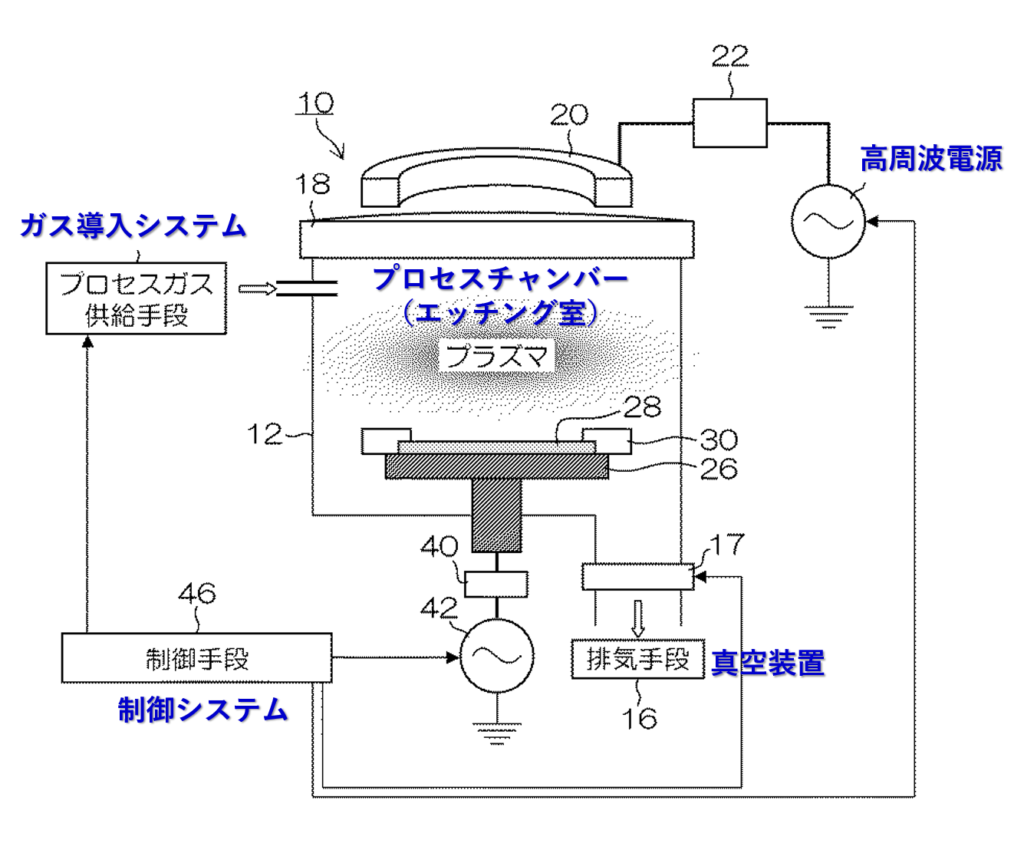
まとめ
今回は、半導体におけるエッチング処理と装置について解説しました。
- エッチングの目的はレジストで被服されていない部分の薄膜を選択的に除去する事
- ドライエッチングの方法は、物理的・化学的の2種類がある
半導体化学メーカー全般を知りたい方は、下記の記事を参照ください。


最後までご覧いただき、ありがとうございました!
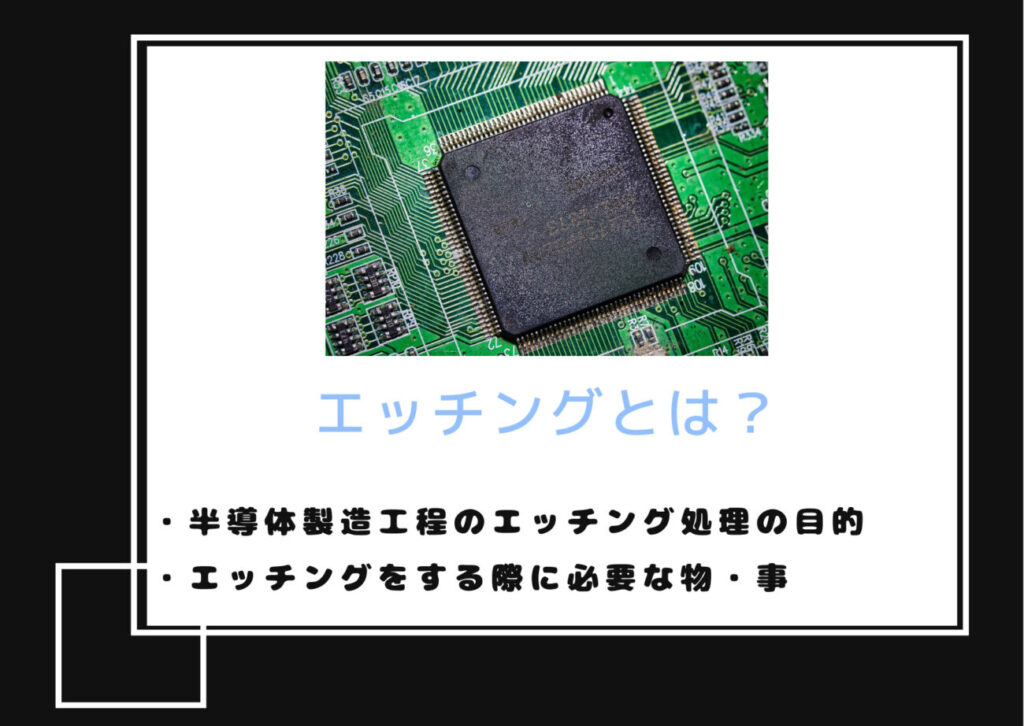



コメント